D-Surface View
DipView
Warpage measurement
D-Surface View provides a FULL SURFACE warpage measurement in one single acquisition. Users can extract critical parameters such as Bow, Warp, TTv, LTv in a few seconds.

Nano-Topography measurement
D-Surface View can explore Nano-topograpgy characteristics and detect polishing inhomogeneities or other nanometer height defects. With powerful fourrier transform filters users can visualise short frequency and high frequency defect patterns.

Data Analytics on a large range of measurement
In one single high resolution image and pure static acquisition D-Surface View can extract from mm level down to nm level in a few seconds, users can explore the full field image at the required resolution and process through Data Analytics algorithms and Open data formats.

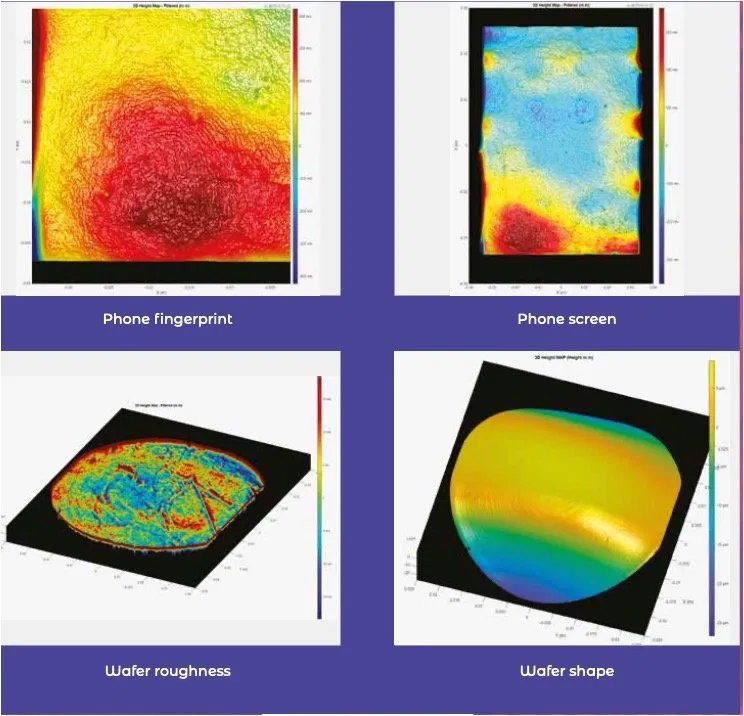
> 2D and 3D step heights with cursors and histography analysis
> 2D profles and 3D views of the measurements
> 2D and 3D roughness and waviness analysis
> 2D and 3D fltering and leveling techniques
> Thin flm stress and sample bow calculation
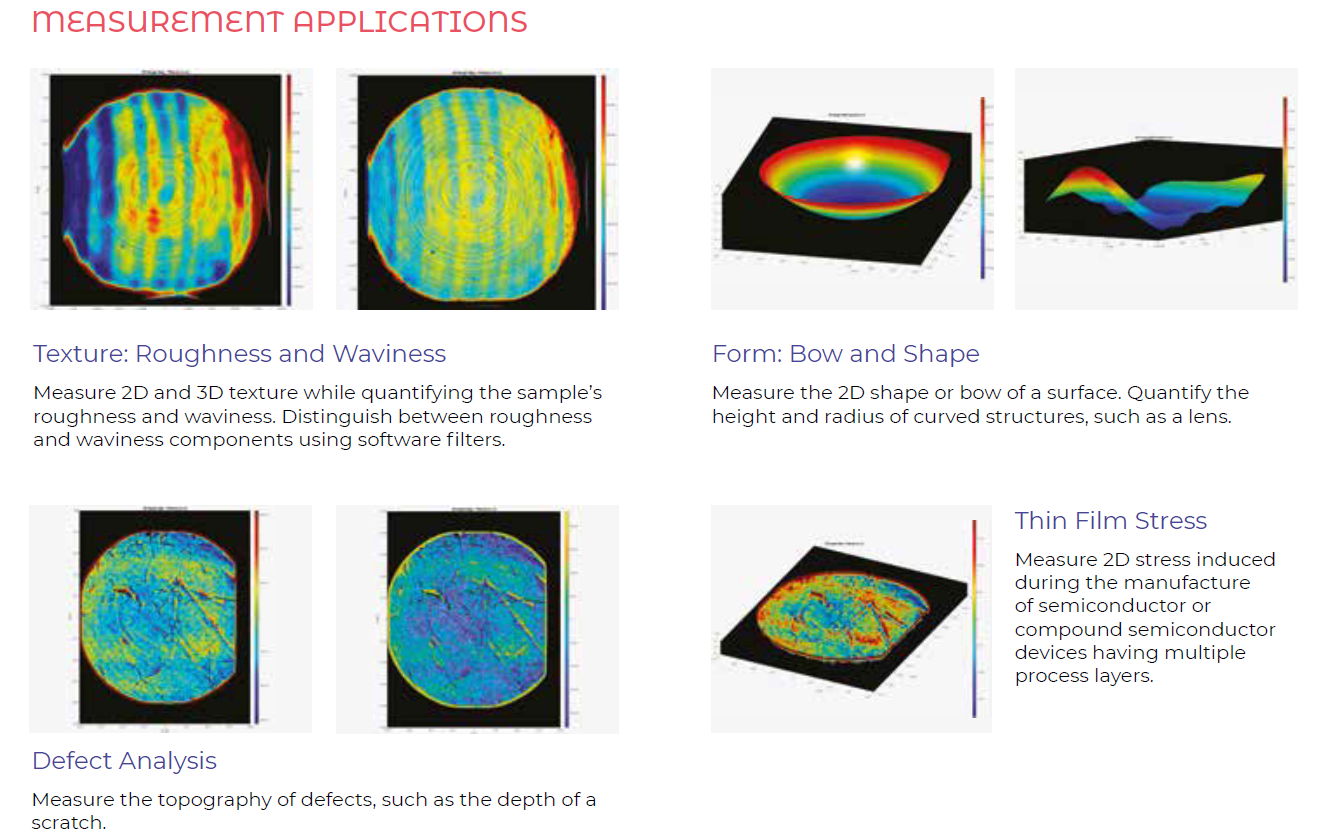
D-Surface View
High Accuracy and Fast 2D and 3D Measurements
D-Surface View is intended to analyze flat surfaces up to 300-mm diameter. The equipment can be used for example forwafer surface quality control, it qualifies surface roughness,shape, flatness, warpage and nano-topography, otherapplications can be automotive mirrors or optical components.D-Surface View provides a FULL SURFACE warpagemeasurement in one single acquisition. Users can extract criticalparameters such as Bow, Warp, TTv, LTv in a few seconds.
D-Surface View can explore Nano-topography characteristicsand detect polishing inhomogeneities or other nanometerheight defects. With powerful Fourier transform filters users canvisualize short frequency and high frequency defect patterns.
Data analytics on a large range of measurement: in one singlehigh resolution image and pure static acquisition D-SurfaceView can extract from mm level down to nm level in a fewseconds, users can explore the full field image at the requiredresolution and process through Data Analytics algorithms and Open data formats.
High Resolution Deflectometry
Surface warpage metrology from Global (mm) to Local (nm) in one shot measurement - Highest Lateral Resolution : 20Mpixels to cover 20mm2